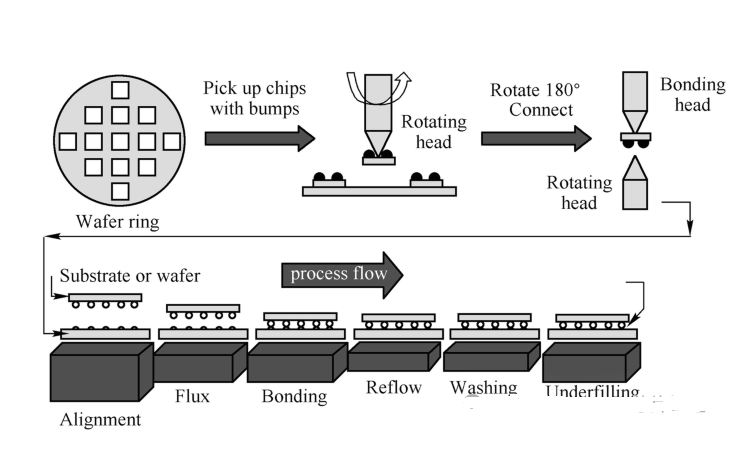
Нехай ’ продовжить вивчати процес розміщення мікросхем.
Як показано на обкладинці.
1. Стружки з нерівностями:
На цьому кроці пластину було нарізано на окремі шматочки, приклеєні до блакитної або ультрафіолетової плівки. Коли потрібно підняти фішки, штифти висуваються знизу, обережно натискаючи на задню частину фішки, трохи піднімаючи її. При цьому вакуумна насадка акуратно підхоплює стружку зверху, тим самим відриваючи стружку від блакитної плівки або УФ плівки.
2. Орієнтація мікросхеми:
Після того, як чіп захоплюється вакуумною насадкою, він передається до головки зв’язування, і під час передачі орієнтація чіпа змінюється таким чином, щоб сторона з нерівностями була спрямована вниз, готовий до вирівнювання з основою.
3. Вирівнювання стружки:
Виступи обертаного чіпа точно вирівняні з подушечками на пакувальній підкладці. Точність вирівнювання має вирішальне значення для того, щоб кожен виступ точно вирівнявся з положенням прокладки на підкладці. Флюс наноситься на контактні площадки на підкладці, який служить для очищення, зменшення поверхневого натягу на кульках припою та сприяє розтоку припою.
4. Склеювання мікросхем:
Після вирівнювання чіп обережно поміщається на підкладку за допомогою зв’язувальної головки з подальшим застосуванням тиску, температури та ультразвукової вібрації, що змушує кульки припою осідати на підкладку, але цей початковий зв'язок не міцний.
5. Переплавлення:
Висока температура процесу паяння оплавленням плавить і розтікає кульки припою, створюючи щільніший фізичний контакт між нерівностями чіпа та контактними майданчиками підкладки. Температурний профіль для пайки оплавленням складається з етапів попереднього нагріву, витримки, оплавлення та охолодження. Коли температура падає, розплавлені кульки припою знову застигають, значно зміцнюючи зв’язок між кульками припою та контактними майданчиками підкладки.
6. Прання:
Після завершення пайки оплавленням на поверхнях мікросхеми та підкладки залишиться залишковий флюс. Тому для видалення залишків флюсу потрібен спеціальний миючий засіб.
7. Заповнення:
Епоксидну смолу або подібний матеріал вводять у зазор між мікросхемою та підкладкою. Епоксидна смола в першу чергу діє як буфер для запобігання тріщинам на нерівностях через надмірне навантаження під час подальшого використання.
8. Лиття:
Після того, як герметизуючий матеріал затвердіє при відповідній температурі, виконується процес формування з наступним тестуванням на надійність та іншими перевірками, що завершує весь процес інкапсуляції чіпа.
Ось і вся інформація про фліп-чіп у техніці SMT. Якщо ви хочете дізнатися більше, просто прийміть замовлення у нас.

 Українська
Українська English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Euskal
Euskal Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba